
解决方案
碳化硅SIC衬底研抛光解决方案
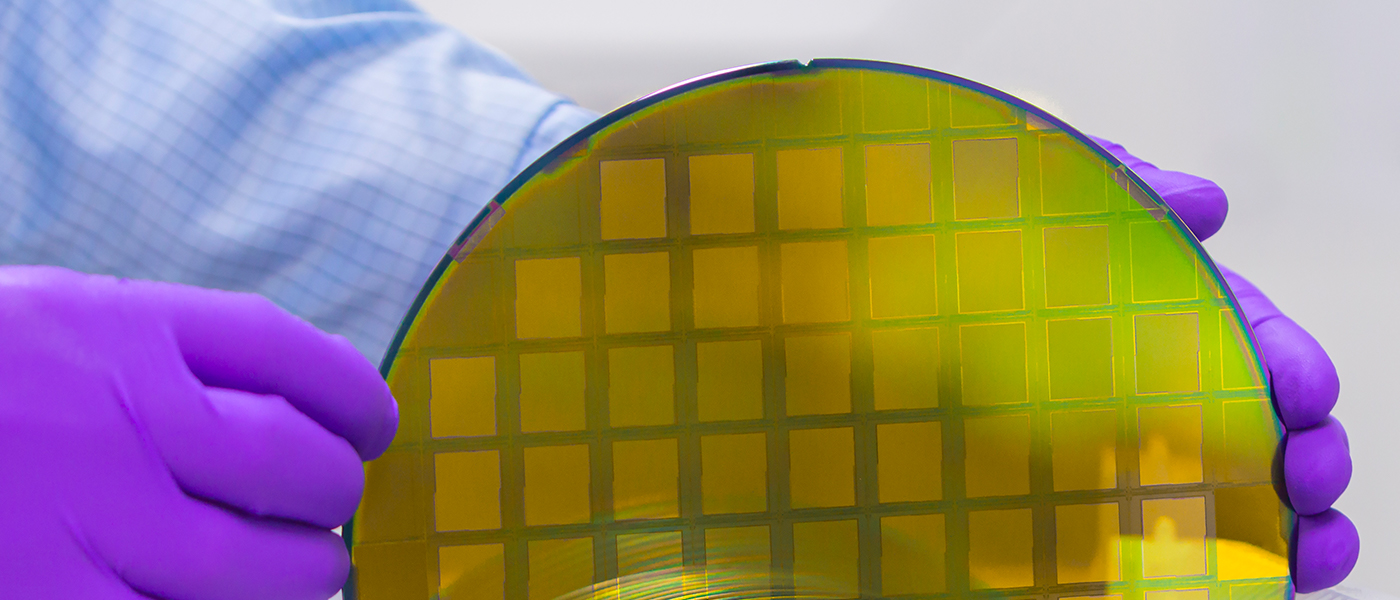
碳化硅晶圆衬底
确保并满足客户在SiC切割研磨抛光等各工段加工参数的前提下,结合客户的实际情况进行有针对性的持续优化,帮助客户不断提升加工效率,有效减短加工时长,提升良品率。 在长期被国外垄断的关键材料应用环节中,逐步实现国产替代,真正为客户做到降本增效。
耗材方案
-
切割工序
a.切割液 NC0630,配合钢线切割晶棒 b.金刚石切割线 DL180,搭配冷却液使用
-
减薄工序
金刚石减薄砂轮 DBG800/DBG1000/ DBG2000/DBG8000
-
研磨工序
a.单晶金刚石研磨液+铸铁盘 b.团聚金刚石研磨液+蜂窝粗磨垫
-
精磨工序
a.聚晶金刚石研磨液+聚氨酯精磨垫 b.团聚金刚石研磨液+聚氨酯精磨垫
-
粗抛工序
a.高锰酸钾氧化铝粗抛液+无纺布研磨垫
-
精抛工序
双组份氧化硅精抛液+黑色阻尼布精抛垫
测试项目参数
-
切割工序
加工耗材:金刚石切割线 加工速度:2800m/min 加工工件: SiC 6”(4H) N-Type 线径尺寸:0.16-0.18mm 加工时间:<20H 耗线量:540-580m/pc 平均厚度:580μm TTV(平均值):<15μm WARP(平均值):<25μm BOW(平均值):<12μm
-
减薄工序
加工耗材:金刚石减薄砂轮(DBG8000) 砂轮粒度:8000# 加工工件: SiC 6”(4H) N-Type 目标厚度:25~30μm 加工速率 :~3μm/min 表面粗糙度(Ra):0.5~2nm 研磨轮寿命:>300pcs
-
DSL粗磨工序
研磨机: 16B设备 加工工件: SiC 6”(4H) N-Type 加工耗材: 单晶金刚石粗磨液 盘面:铸铁盘 移除率: 1.1~1.4μm/min 总移除厚度: 70~80μm 表面粗糙度(Ra):~30nm TTV: <3μm
-
DMP精磨工序
研磨机: 16B设备 加工工件: SiC 6”(4H) N-Type 加工耗材: 聚晶金刚石精磨液 盘面:无纺布粗抛垫 移除率: 0.2~0.3μm/min 总移除厚度: 20~30μm 表面粗糙度(Ra):3~5nm TTV: <3μm
-
双面CMP工序
研磨机: 18B设备 加工工件: SiC 6”(4H) N-Type 加工耗材: 氧化铝粗抛液 盘面:无纺布粗抛垫(LZ-NWF2P-85) 移除率: 0.05~0.06μm/min 总移除厚度: 15μm 表面粗糙度(Ra):~0.2nm TTV: <3μm
-
单面CMP工序
研磨机: 13B设备 加工工件: SiC 6”(4H) N-Type 加工耗材: 氧化硅粗抛液 盘面:黑色阻尼布精抛垫(LZ-NZN) 移除率: 0.005~0.01μm/min 总移除厚度: 1μm 表面粗糙度(Ra):~0.1nm TTV: <3μm
*以上参数仅供参考,根据客户定制。